Obecnie istnieją dwa główne typy FET: Tranzystory JFET i MOSFET.
Tranzystory MOSFET można dalej podzielić na typ zubożenia i rodzaj wzmocnienia. Oba te typy określają podstawowy tryb działania tranzystorów MOSFET, podczas gdy sam termin MOSFET jest skrótem tranzystora polowego z tlenkiem metalu i półprzewodnikiem.
Ze względu na to, że te dwa typy mają różne właściwości robocze, będziemy oceniać każdy z nich oddzielnie w różnych artykułach.
Różnica między wzmacniającym a wyczerpującym tranzystorem MOSFET
Zasadniczo, w przeciwieństwie do wzmacniających tranzystorów MOSFET, tranzystory MOSFET zubażania są w stanie włączenia nawet przy napięciu 0 V na zaciskach typu bramka-źródło (VGS).
W przypadku wzmacniającego tranzystora MOSFET, napięcie bramki do źródła (VGS) musi być powyżej jego napięcia progowego między bramką a źródłem (VGS (th)) aby to się stało .
Jednak w przypadku tranzystora MOSFET zubożonego w kanale N jego wartość VGS (th) jest wyższa niż 0 V. Oznacza to, że nawet jeśli VGS = 0 V, tranzystor MOSFET zubażający jest w stanie przewodzić prąd. Aby go wyłączyć, VGS zubożonego MOSFET-u musi zostać zmniejszone poniżej VGS (th) (ujemny).
W tym artykule omówimy tranzystory MOSFET typu zubożonego, o których mówi się, że mają charakterystykę pasującą do JFET. Podobieństwo występuje między odcięciem a nasyceniem w pobliżu IDSS.
Podstawowa konstrukcja

Rys. 5.23 przedstawia podstawową strukturę wewnętrzną n-kanałowego tranzystora MOSFET typu zubożonego.
Możemy znaleźć blok materiału typu p utworzony na bazie silikonu. Ten blok nazywa się podłożem.
Podłoże to podstawa lub fundament, na którym zbudowany jest MOSFET. W przypadku niektórych tranzystorów MOSFET jest on wewnętrznie połączony z terminalem „źródłowym”. Ponadto wiele urządzeń oferuje dodatkowe wyjście w postaci SS, wyposażone w 4-terminalowy MOSFET, jak pokazano na rysunku 5.23.
Dren i zaciski źródła są połączone za pomocą styków przewodzących z miejscami domieszkowanymi n i przymocowane przez kanał n, jak pokazano na tym samym rysunku.
Brama jest również połączona z warstwą metaliczną, chociaż jest izolowana od kanału n cienką warstwą dwutlenku krzemu (SiOdwa).
SiOdwaposiada unikalną formę właściwości izolacyjnych zwaną dielektrykiem, która tworzy w sobie przeciwstawne pole elektryczne w odpowiedzi na zewnętrzne pole elektryczne.
Będąc warstwą izolacyjną, materiał SiOdwaoferuje nam następujące ważne informacje:
Za pomocą tego materiału opracowano pełną izolację między terminalem bramki a kanałem mosfet.
Co więcej, jest to spowodowane SiOdwa, bramka mosfetu jest w stanie charakteryzować się niezwykle wysokim stopniem impedancji wejściowej.
Ze względu na tę istotną właściwość wysokiej impedancji wejściowej prąd bramki Isolto praktycznie zero amperów dla dowolnej konfiguracji MOSFET z obciążeniem DC.
Podstawowa obsługa i charakterystyka

AS można zobaczyć na ryc. 5.24, bramka do źródła napięcia została skonfigurowana na zero woltów przez połączenie dwóch zacisków razem, podczas gdy napięcie VDSjest nakładany na zaciski spustowe i źródłowe.
Przy powyższym ustawieniu, strona drenu ustanawia dodatni potencjał przez n-kanałowe swobodne elektrony, wraz z równoważnym prądem płynącym przez kanał JFET. Również wynikowy prąd VGS= 0 V jest nadal identyfikowany jako IDSS, jak pokazano na rys. 5.25

Widzimy, że na rysunku 5.26 napięcie źródła bramki VGSma ujemny potencjał w postaci -1V.
Ten ujemny potencjał próbuje zmusić elektrony w kierunku podłoża kanału p (ponieważ ładunki odpychają) i wyciągnąć dziury z podłoża kanału p (ponieważ przyciągają się przeciwne ładunki).

W zależności od tego, jak duże jest to negatywne odchylenie VGSOznacza to, że zachodzi rekombinacja dziur i elektronów, w wyniku której następuje redukcja wolnych elektronów w kanale n dostępnym do przewodzenia. Wyższe poziomy negatywnego odchylenia skutkują wyższym współczynnikiem rekombinacji.
W konsekwencji prąd drenu jest zmniejszany, ponieważ powyższy warunek ujemnej polaryzacji jest zwiększony, co pokazano na rys. 5.25 dla VGSpoziomy VGS= -1, -2 i tak dalej, aż do oznaczenia -6V.
W rezultacie prąd drenu wraz z wykresem krzywej przenoszenia przebiega podobnie jak w przypadku JFET.
Teraz dla pozytywnych VGSwartości, bramka dodatnia będzie przyciągać nadmiar elektronów (wolnych nośników) z podłoża typu p ze względu na zwrotny prąd upływu. Pozwoli to ustalić nowe nośniki w wyniku zderzeń w przyspieszających cząstkach.
Ponieważ napięcie między bramką a źródłem ma tendencję do zwiększania się z prędkością dodatnią, prąd drenu wykazuje szybki wzrost, jak pokazano na rys. 5.25 z tych samych powodów, co omówiono powyżej.
Luka powstała między krzywymi VGS= 0 V i V.GS= +1 wyraźnie pokazuje wielkość, o jaką prąd wzrósł w wyniku zmiany 1 - V VGS
Ze względu na szybki wzrost prądu drenu musimy uważać na maksymalny prąd znamionowy, w przeciwnym razie może on przekroczyć dodatnią granicę napięcia bramki.
Na przykład dla typu urządzenia przedstawionego na rys. 5.25, stosując VGS= + 4 V spowodowałoby wzrost prądu drenu przy 22,2 mA, który może przekroczyć maksymalną granicę przebicia (prąd) urządzenia.
Powyższy warunek pokazuje, że użycie dodatniego napięcia bramka-źródło generuje zwiększony wpływ na ilość wolnych nośnych w kanale, w przeciwieństwie do sytuacji, gdy VGS= 0V.
Dlatego dodatni obszar napięcia bramki na charakterystyce drenu lub przenoszenia jest ogólnie znany jako region wzmocnienia . Region ten leży pomiędzy granicą odcięcia a poziomem nasycenia IDSSlub region zubożenia.
Rozwiązywanie przykładowego problemu

Zalety i zastosowania
W przeciwieństwie do tranzystorów MOSFET w trybie wzmocnienia, w których prąd drenu spada do zera w odpowiedzi na zerowe napięcie bramki do źródła, nowoczesny tranzystor FET w trybie wyczerpywania charakteryzuje się zauważalnym prądem przy zerowym napięciu bramki. Mówiąc dokładniej, rezystancja między drenem a źródłem wynosi zwykle 100 omów przy zerowym napięciu.

Jak pokazano na powyższym wykresie, wartości rezystancji włączenia(na)vs analogowy zakres sygnału wygląda na praktycznie płaską odpowiedź. Ta charakterystyka, w połączeniu z niskimi poziomami pojemności tego zaawansowanego urządzenia typu zubożonego, sprawia, że są one szczególnie idealne jako przełączniki analogowe do zastosowań przełączających audio i wideo.
Atrybut „normalnie włączony” tranzystora MOSFET w trybie zubożenia umożliwia idealne dopasowanie urządzenia do pojedynczych regulatorów prądu FET.
Jeden taki przykładowy obwód można zobaczyć na poniższym rysunku.

Wartość Rs można określić za pomocą wzoru:
Rs= VGSpoza[1 - (Ire/JADSS)1/2] / JAre
gdzie jare jest ilością regulowanego prądu wymaganego na wyjściu.
Główną zaletą tranzystorów MOSFET w trybie zubożonym w zastosowaniach ze źródłem prądu jest ich minimalna pojemność drenu, co czyni je odpowiednimi do zastosowań polaryzacyjnych w obwodach prądu upływowego o niskim wejściu i średniej prędkości (> 50 V / us).
Poniższy rysunek przedstawia front-end różnicowy o niskim prądzie upływu wejściowym, wykorzystujący podwójną funkcję FET o niskiej upływności.

Ogólnie rzecz biorąc, każda strona JFET będzie obciążona przy ID = 500 uA. Dlatego prąd możliwy do uzyskania w celu kompensacji ładowania i pojemności rozproszonych jest ograniczony do 2ID lub, w takich przypadkach, do 1,0 mA. Odpowiednie funkcje JFET są sprawdzone w produkcji i zapewnione w arkuszu danych.
Cs symbolizuje pojemność wyjściową źródła prądu „ogona” stopnia wejściowego. Ta pojemność jest kluczowa we wzmacniaczach nieodwracających, ze względu na fakt, że stopień wejściowy doświadcza znacznych wymian sygnału w tej sieci, a prądy ładowania w C mogą być duże. W przypadku zastosowania normalnych źródeł prądu, ta pojemność ogonowa może być odpowiedzialna za zauważalne pogorszenie szybkości narastania w obwodach nieodwracających (w porównaniu do aplikacji odwracających, gdzie prądy ładowania w C są zwykle minimalne).
Spadek szybkości zmian można wyrazić jako:
1 / 1+ (Cs / Sc)
Dopóki Cs jest niższe niż Cc (kondensator kompensacyjny), może nie być prawie żadnych zmian w szybkości narastania. Pracując z DMOS FET, Cs może wynosić około 2 pF. Ta strategia daje ogromną poprawę szybkości narastania. Tam, gdzie potrzebne są deficyty prądu większe niż 1 do 5 mA, urządzenie może zostać przełączone w tryb wzmocnienia, aby wygenerować nawet 20 mA dla maksymalnego VGS +2,5 V, przy minimalnej pojemności wyjściowej nadal kluczowym aspektem.
Następna aplikacja poniżej przedstawia prawidłowy obwód źródła prądu w trybie wzmocnienia.

Przełącznik analogowy „normalnie włączony” mógłby być zbudowany na potrzeby wymagań, w których stan normalny staje się konieczny podczas awarii napięcia zasilania, na przykład w przypadku automatycznego doboru narzędzi testowych lub w celu zapewnienia dokładnego uruchomienia obwodów logicznych przy włączaniu.
Zmniejszone ujemne napięcie progowe urządzenia zapewnia podstawowe warunki napędu i umożliwia pracę przy minimalnym napięciu.
Poniższy obwód przedstawia wspólne współczynniki odchylenia dla dowolnego przełącznika analogowego DMOS w trybie wyczerpywania.

Aby spowodować wyłączenie urządzenia, na bramie konieczne jest wystąpienie ujemnego napięcia. Powiedziawszy to, rezystancja włączenia może być zminimalizowana, gdy FET jest dodatkowo wzmocniony za pomocą dodatniego napięcia bramki, umożliwiając to szczególnie w obszarze trybu wzmocnienia wraz z obszarem trybu zubożenia.
Tę odpowiedź można zobaczyć na poniższym wykresie.

Wzmocnienie wysokiej częstotliwości urządzenia, wraz z jego niskimi wartościami pojemności, zapewnia zwiększoną „wartość”. Jest to naprawdę kluczowy element we wzmacnianiu VHF i UHF, który określa iloczyn wzmocnienia pasma (GBW) tranzystora FET, który można przedstawić jako:
GBW = gfs / 2 Liczba Pi (DOw+ Cna zewnątrz)
MOSFET typu zubożonego kanału p
Konstrukcja tranzystora MOSFET z kanałem typu p jest doskonałym odwrotnością wersji n-kanałowej pokazanej na rys. 5.23. Oznacza to, że podłoże przyjmuje teraz postać typu n, a kanał staje się typem p, co widać na rysunku 5.28a poniżej.

Identyfikacja zacisków pozostaje niezmieniona, ale polaryzacja napięcia i prądu jest odwrócona, jak pokazano na tym samym rysunku. Charakterystyka odpływu byłaby dokładnie taka, jak pokazano na rysunku 5.25, z wyjątkiem VDSznak, który w tym przypadku będzie miał wartość ujemną.
Prąd spustowy Irewykazuje dodatnią polaryzację również w tym przypadku, ponieważ już odwróciliśmy jej kierunek. VGSpokazuje przeciwną biegunowość, co jest zrozumiałe, jak pokazano na ryc. 5.28c.
Ponieważ V.GSjest odwrócony tworzy lustrzane odbicie charakterystyk przenoszenia, jak pokazano na rys. 5, 28b.
Oznacza to, że prąd drenu rośnie w dodatnim V.GSregion od punktu odcięcia w VGS= Vp do IDSS, to nadal rośnie jako ujemna wartość VGSrośnie.
Symbolika

Graficzne znaki dla tranzystora MOSFET z kanałem typu n i p można zobaczyć na powyższym rys. 5.29.
Zwróć uwagę, w jaki sposób wybrane symbole mają przedstawiać prawdziwą konstrukcję urządzenia.
Brak bezpośredniego połączenia (ze względu na izolację bramki) między bramką a kanałem jest symbolizowany przez przerwę między bramką a różnymi zaciskami symbolu.
Pionowa linia reprezentująca kanał jest przymocowana między odpływem a źródłem i jest „utrzymywana” przez podłoże.
Na powyższym rysunku przedstawiono dwie grupy symboli dla każdego typu kanału, aby podkreślić fakt, że w niektórych urządzeniach podłoże może być dostępne z zewnątrz, podczas gdy w innych może to być niewidoczne.
MOSFET (typ wzmocnienia)
Chociaż tranzystory MOSFET typu zubożonego i typu wzmocnienia wyglądają podobnie pod względem struktury wewnętrznej i trybu funkcjonalnego, ich charakterystyka może być całkiem inna.
Główną różnicą jest prąd drenu, który zależy od określonego poziomu napięcia między bramką a źródłem dla działania odcinającego.
Dokładniej, n-kanałowy tranzystor MOSFET typu wzmacniającego może pracować z dodatnim napięciem bramki / źródła zamiast zakresu ujemnych potencjałów, które normalnie mogą wpływać na tranzystor MOSFET typu zubożonego.
Podstawowa konstrukcja
Poniżej można zwizualizować n-kanałowy wzmacniacz MOSFET
Ryc. 5.31.
Sekcja materiału typu p jest tworzona przez podstawę silikonową i, jak nauczono wcześniej, jest określana jako podłoże.

To podłoże w niektórych przypadkach jest połączone wewnętrznie z pinem źródłowym w tranzystorze MOSFET typu zubożonego, podczas gdy w niektórych przypadkach jest zakończone jako czwarte doprowadzenie, aby umożliwić zewnętrzną kontrolę jego potencjalnego poziomu.
Końcówki źródła i spustu są jak zwykle połączone za pomocą metalowych styków z obszarami domieszkowanymi n.
Jednak może być ważne, aby zwizualizować, że na ryc. 5.31 brakuje kanału między dwoma obszarami domieszkowanymi n.
Można to uznać za fundamentalną odmienność między układem wewnętrznym tranzystora MOSFET typu zubożonego i typu wzmacniającego, czyli brak wewnętrznego kanału, który ma być częścią urządzenia.
Warstwa SiO2 jest nadal obecna, co zapewnia izolację między metalową podstawą końcówki bramki a obszarem między odpływem a źródłem. Jednak tutaj można go zobaczyć stojąc oddzielony od sekcji materiału typu p.
Z powyższej dyskusji możemy wywnioskować, że wewnętrzny układ MOSFET z uszczupleniem i ulepszeniem może mieć pewne podobieństwa, z wyjątkiem brakującego kanału między drenem / źródłem dla typu wzmocnienia MOSFET.
Podstawowa obsługa i charakterystyka
W przypadku wzmacniacza typu MOSFET, gdy 0 V jest wprowadzane do jego VGS, z powodu brakującego kanału n (który jest znany z przenoszenia wielu wolnych nośnych) powoduje, że prąd wyjściowy wynosi zero, co jest zupełnie inne niż w przypadku typu zubożonego MOSFET, mający ID = IDSS.
W takiej sytuacji ze względu na brakującą ścieżkę przez końcówki drenu / źródła duże ilości nośników w postaci elektronów nie są w stanie gromadzić się w drenach / źródłach (z powodu obszarów z domieszką n).
Stosując pewien dodatni potencjał w VDS, z VGS ustawionym na zero woltów i zaciskiem SS zwartym z zaciskiem źródła, faktycznie znajdujemy kilka odwrotnych polaryzowanych połączeń pn między regionami domieszkowanymi n a substratem p, aby umożliwić jakiekolwiek zauważalne przewodzenie w poprzek spuścić do źródła.

Na ryc. 5.32 pokazano stan, w którym VDS i VGS są przyłożone z pewnym dodatnim napięciem wyższym niż 0 V, co pozwala drenowi i bramce mieć dodatni potencjał w stosunku do źródła.
Dodatni potencjał na bramce popycha otwory w p-substracie wzdłuż krawędzi warstwy SiO2, opuszczając lokalizację i wchodząc głębiej w obszary p-substratu, jak pokazano na powyższym rysunku. Dzieje się tak z powodu odpychających się podobnych ładunków.
Skutkuje to utworzeniem obszaru zubożenia w pobliżu warstwy izolacyjnej SiO2, który jest pozbawiony otworów.
Mimo to elektrony p-substratu, które są mniejszościowymi nośnikami materiału, są przyciągane w kierunku bramki dodatniej i zaczynają gromadzić się w obszarze bliskim powierzchni warstwy SiO2.
Dzięki właściwościom izolacyjnym warstwy SiO2 nośniki ujemne pozwalają na wchłanianie nośników ujemnych na terminalu bramki.
Gdy zwiększamy poziom VGS, gęstość elektronów w pobliżu powierzchni SiO2 również rośnie, aż w końcu indukowany region typu n jest w stanie umożliwić mierzalne przewodzenie przez dren / źródło.
Wielkość VGS, która powoduje optymalny wzrost prądu drenu, określa się jako napięcie progowe, oznaczane symbolem VT . W arkuszach danych będzie można zobaczyć to jako VGS (Th).
Jak wspomniano powyżej, ze względu na brak kanału przy VGS = 0 i „ulepszony” przy zastosowaniu dodatniego napięcia bramki do źródła, ten typ MOSFET jest znany jako tranzystory MOSFET typu wzmacniającego.
Przekonasz się, że zarówno tranzystory MOSFET typu zubożonego, jak i ze wzmocnieniem wykazują regiony typu wzmocnionego, ale termin wzmocnienie jest używany w tym drugim przypadku, ponieważ działa on specjalnie przy użyciu trybu wzmocnienia.
Teraz, gdy VGS zostanie przesunięty powyżej wartości progowej, stężenie wolnych nośnych wzrośnie w kanale, w którym jest indukowane. Powoduje to wzrost prądu drenu.
Z drugiej strony, jeśli utrzymamy VGS na stałym poziomie i zwiększymy poziom VDS (napięcie drenu do źródła), ostatecznie spowoduje to, że tranzystor MOSFET osiągnie swój punkt nasycenia, jak zwykle ma to miejsce w przypadku każdego JFET-a lub tranzystora MOSFET ze zubożeniem.

Jak pokazano na rys. 5.33, prąd drenu ID zostaje wyrównany za pomocą procesu zaciskania, na co wskazuje węższy kanał w kierunku końca drenu indukowanego kanału.
Stosując prawo napięcia Kirchhoffa do napięć na zaciskach tranzystora MOSFET na rys. 5.33, otrzymujemy:

Jeśli VGS jest utrzymywane na stałym poziomie do określonej wartości, na przykład 8 V, a VDS jest podwyższane z 2 do 5 V, napięcie VDG jest równe. 5.11 można było zobaczyć spadając z -6 do -3 V, a potencjał bramki stawał się coraz mniej dodatni w odniesieniu do napięcia drenu.
Ta odpowiedź uniemożliwia przyciąganie wolnych nośników lub elektronów w kierunku tego obszaru indukowanego kanału, co z kolei skutkuje spadkiem efektywnej szerokości kanału.
Ostatecznie szerokość kanału zmniejsza się do punktu zerwania, osiągając stan nasycenia podobny do tego, czego nauczyliśmy się już w naszym wcześniejszym artykule o zubożeniu MOSFET-u.
Oznacza to, że dalsze zwiększenie VDS przy stałym VGS nie wpływa na poziom nasycenia ID, aż do momentu osiągnięcia sytuacji awaryjnej.
Patrząc na rys. 5.34, możemy stwierdzić, że dla MOSFET-u jak na ryc. 5.33 o VGS = 8 V, nasycenie zachodzi przy poziomie VDS 6 V. Dokładniej, poziom nasycenia VDS jest powiązany z zastosowanym poziomem VGS przez:

Bez wątpienia oznacza to zatem, że gdy wartość VT jest stała, zwiększenie poziomu VGS będzie proporcjonalnie powodować wyższe poziomy nasycenia dla VDS poprzez miejsce poziomów nasycenia.
Nawiązując do charakterystyk przedstawionych na powyższym rysunku, poziom VT wynosi 2 V, o czym świadczy fakt, że prąd drenu spadł do 0 mA.
Dlatego zazwyczaj możemy powiedzieć:
Gdy wartości VGS są mniejsze niż poziom progowy dla tranzystora MOSFET typu wzmacniającego, jego prąd drenu wynosi 0 mA.

Na powyższym rysunku możemy również wyraźnie zobaczyć, że tak długo, jak VGS jest podwyższany z VT do 8 V, odpowiedni poziom nasycenia dla ID również wzrasta z poziomu 0 do 10 mA.
Ponadto możemy dalej zauważyć, że przestrzeń między poziomami VGS zwiększa się wraz ze wzrostem wartości VGS, powodując nieskończenie narastające przyrosty prądu drenu.
Stwierdzamy, że wartość prądu drenu jest powiązana z napięciem od bramki do źródła dla poziomów VGS, które są większe niż VT, poprzez następującą zależność nieliniową:

Termin, który jest przedstawiony w kwadratowym nawiasie, jest terminem odpowiedzialnym za nieliniową zależność między ID i VGS.
Termin k jest stałą i jest funkcją układu MOSFET.
Wartość tej stałej k możemy znaleźć za pomocą następującego równania:
gdzie ID (wł.) i VGD (wł.) są wartościami zależnymi od charakterystyki urządzenia.


Na następnym Rys. 5.35 poniżej widzimy, że dren i charakterystyka przenoszenia są ułożone jedna obok drugiej, aby wyjaśnić proces przenoszenia między sobą.
Zasadniczo jest podobny do procesu wyjaśnionego wcześniej dla JFET i tranzystorów MOSFET typu zubożonego.
Jednak w tym przypadku musimy pamiętać, że prąd drenu wynosi 0 mA dla VGS VT.
Tutaj ID może zobaczyć zauważalną ilość prądu, która wzrośnie zgodnie z równaniem. 5.13.
Uwaga: podczas definiowania punktów nad charakterystyką przenoszenia z charakterystyk drenu, bierzemy pod uwagę tylko poziomy nasycenia. Ogranicza to obszar działania do wartości VDS wyższych niż poziomy nasycenia ustalone przez równanie. (5.12).



Tranzystory MOSFET z ulepszeniem kanału p
Struktura tranzystora MOSFET typu wzmacniającego kanał p, jak pokazano na rys. 5.37a, jest dokładnie odwrotna do pokazanej na rys. 5.31.
To znaczy, teraz odkrywasz, że podłoże typu n i obszary domieszkowane p pod drenami i złączami źródłowymi.
Zaciski są nadal zgodne z ustaleniami, ale każdy z kierunków prądu i polaryzacji napięcia są odwrócone.
Charakterystyka drenu może wyglądać tak, jak pokazano na rys. 5.37c, przy rosnących ilościach prądu spowodowanych przez coraz bardziej ujemne wartości VGS.

Charakterystyka przenoszenia byłaby odbiciem lustrzanym (wokół osi ID) krzywej przenoszenia z fig. 5.35, przy czym ID rośnie wraz z coraz bardziej ujemnymi wartościami VGS powyżej VT, jak pokazano na fig. 5.37b. Równania od (5.11) do (5.14) są podobnie odpowiednie dla urządzeń z kanałem p.
Bibliografia:
- https://en.wikipedia.org/wiki/MOSFET
- https://hi.wikipedia.org/wiki/%E0%A4%AE%E0%A5%89%E0%A4%B8%E0%A4%AB%E0%A5%87%E0%A4%9F
Poprzedni: Obwód detektora RF Anti Spy - bezprzewodowy wykrywacz błędów Dalej: Charakterystyka transferu

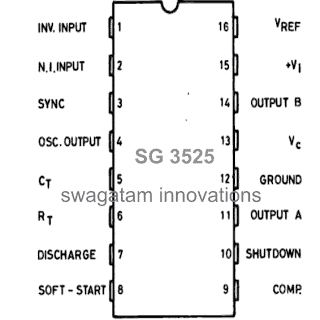
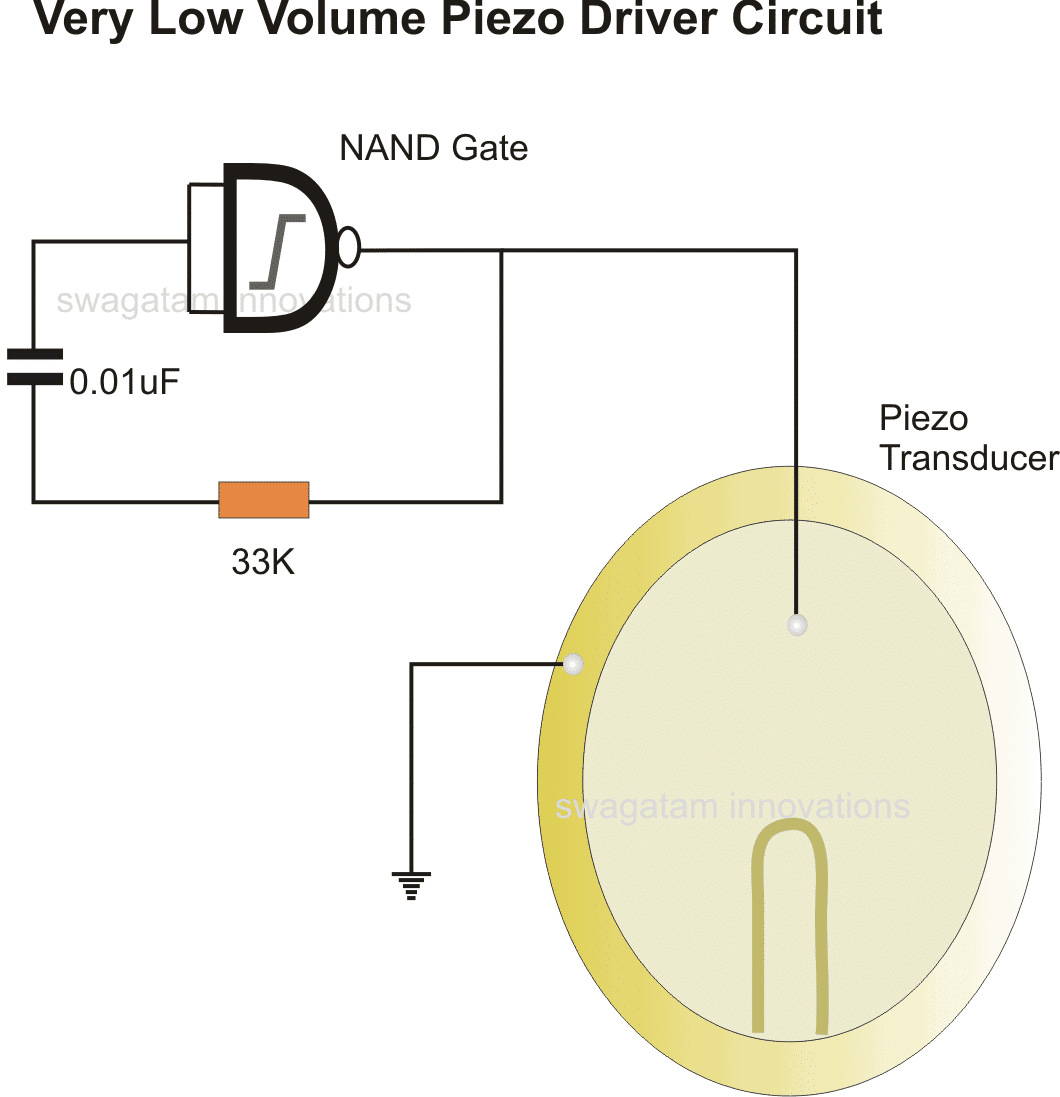

![Zbuduj prosty obwód konwertera Buck [przetwornik Step Down]](https://electronics.jf-parede.pt/img/3-phase-power/D0/build-a-simple-buck-converter-circuit-step-down-converter-1.jpg)